Dieser Artikel ist der erste Artikel zu Leiterplattenbestückungstechnologien. Das letzte Seminar von PCB SOFT war dem Design gewidmet, um die Herstellbarkeit der Leiterplatte (DFM, Design for Manufacturing) sicherzustellen. Es wurde die Frage aufgeworfen, ob es geeignet ist, bleifreie BGA-Komponenten für hochzuverlässige Anwendungen neu zu kombinieren. Sowohl die Organisatoren des Seminars als auch die Teilnehmer äußerten sich zuversichtlich, dass niemand diese arbeitsintensive Operation durchführte und nie auf Probleme gestoßen war. In diesem Artikel werde ich dieses Problem kritisch untersuchen und versuchen, die Gefahr solcher "in der Branche allgemein akzeptierten" Meinungen über die Vorteile der universellen Zweifelsmethode des alten Rene Descartes aufzuzeigen.
Im Jahr 2006 wurde die
RoHS- Richtlinie verabschiedet, die die Verwendung von Blei und anderen anerkannten schädlichen Elementen in der Verbraucher- und Industrieelektronik einschränkt. Dies führte dazu, dass die meisten Hersteller elektronischer Komponenten auf bleifreie Gehäuse umstellten und die Bestellung von Komponenten in Versionen mit bleihaltigen Kabeln nicht immer verfügbar ist. Gleichzeitig ist die Technologie des Lötens mit Loten mit einem hohen Bleigehalt nicht verschwunden (in
GOST R 56427-2015 wird sie übrigens als traditionell bezeichnet). Die Wahl des Lots und / oder der Lötpaste liegt beim Leiterplattenentwickler. Wenn also die Wahl zugunsten eines bleihaltigen Lots getroffen wird, besteht ein Problem beim Löten bleifreier Komponenten (englisches Mischlegierungsverfahren), insbesondere in Fällen vom BGA-Typ (Verhältnismäßigkeit der Lötmittelanteile). Das Hauptproblem ist die Auswirkung des Lötmittels auf die Zuverlässigkeit der Verbindung. Das obige GOST gibt eine eindeutige Antwort:
Bei RES der Klasse C gemäß
GOST R IEC 61191-1-2010 ist ein Fehler nicht akzeptabel. Das Gerät muss jederzeit funktionieren, auch unter rauen Bedingungen. Diese Anforderungen gelten nicht nur für Geräte für Militär- und Weltraumanwendungen. Beispielsweise müssen verantwortungsbewusste industrielle Systeme auch zuverlässig sein.
Wo ist diese Anforderung in GOST entstanden? Dies ist eine Frage für die Entwickler des Standards, die höchstwahrscheinlich den ausländischen Standard übersetzt haben, der wahrscheinlich bereits 5-10 Jahre alt ist, und woher er stammt, ist überhaupt nicht bekannt. Gleichzeitig schüttelten die Teilnehmer des Seminars, über das ich zu Beginn schrieb und die ein Stück Haushaltselektronik mit genau verantwortungsvoller Anwendung darstellten, bei dem Wort „reballing“ den Kopf. Vielleicht haben sie eine positive Erfahrung, ich argumentiere nicht, ich bin einfach gegen Verallgemeinerungen und Zusicherungen, die auf Unwissenheit beruhen. Wer von ihnen (und von euch Lesern) hat den Standard gelesen? Und diejenigen, die dem Standard folgen, sind sich sicher, dass dieser Vorgang im Herstellungsprozess in ihrem speziellen Fall erforderlich ist? Die Operation selbst verringert nicht die Zuverlässigkeit? Wer hat eine experimentelle Studie zur Zuverlässigkeit der verwendeten Oberflächenmontagetechnologie durchgeführt? Weil der springende Punkt im Experiment liegt, im richtig eingestellten Experiment. Eine weitere Informationsquelle ist die Analyse verfügbarer Daten von Drittforschern. Im Folgenden werde ich einige Artikel über die Zuverlässigkeit des Lötens bleifreier Komponenten zusammenfassen.
Die Schmelztemperatur (
Liquidus ,
TL ) bleifreier Lote ist 30–40
° C höher als die bleihaltiger Lote. Je nach thermischem Profil des Lötens und Verteilung des thermischen Feldes auf der Leiterplatte können daher verschiedene Mischungsgrade in der Lötstelle erzielt werden (Abb. 1). Das Vorhandensein von Konzentrationszonen und Inhomogenitäten sowohl der Metalle selbst als auch der intermetallischen Verbindungen in der Lötstelle (Abb. 2) verringert die langfristige Zuverlässigkeit, da solche Makrostrukturen die wahrscheinlichsten Orte für die Bildung und Ausbreitung von Rissen sind (insbesondere bei niedrigen Temperaturen). Obwohl die meisten Artikel aus der Literaturliste eine Analyse von Mikrophotographien des Querschnitts der Verbindungen liefern, wird eine einheitliche Theorie der Ursache von Rissen nicht beobachtet.


Tabelle 1 fasst die Ergebnisse von Forschungsarbeiten zusammen, die auf dem folgenden typischen Experiment basierten: Für eine feste Kombination von Loten ist die BGA-Komponente (in einigen Experimenten ist dies ein nicht funktionales Komponentenlayout, bei dem nur Verbindungen für die Schlussfolgerungen zum Aufbau einer seriellen Schaltung vorhanden sind) mit verschiedenen thermischen Profilen versiegelt; thermocyclisiert, bis ein Funktionsfehler oder ein berührungsloser Kontakt auftrat. Die Abhängigkeit von der Größe des Gehäuses wurde ebenfalls untersucht. In einer Reihe von Arbeiten wurde der Einfluss der Position des Bauteils auf der Leiterplatte, die Wirkung von Klebstoff wie „Unterfüllung“, die Oberfläche der Leiterplatte usw. untersucht.
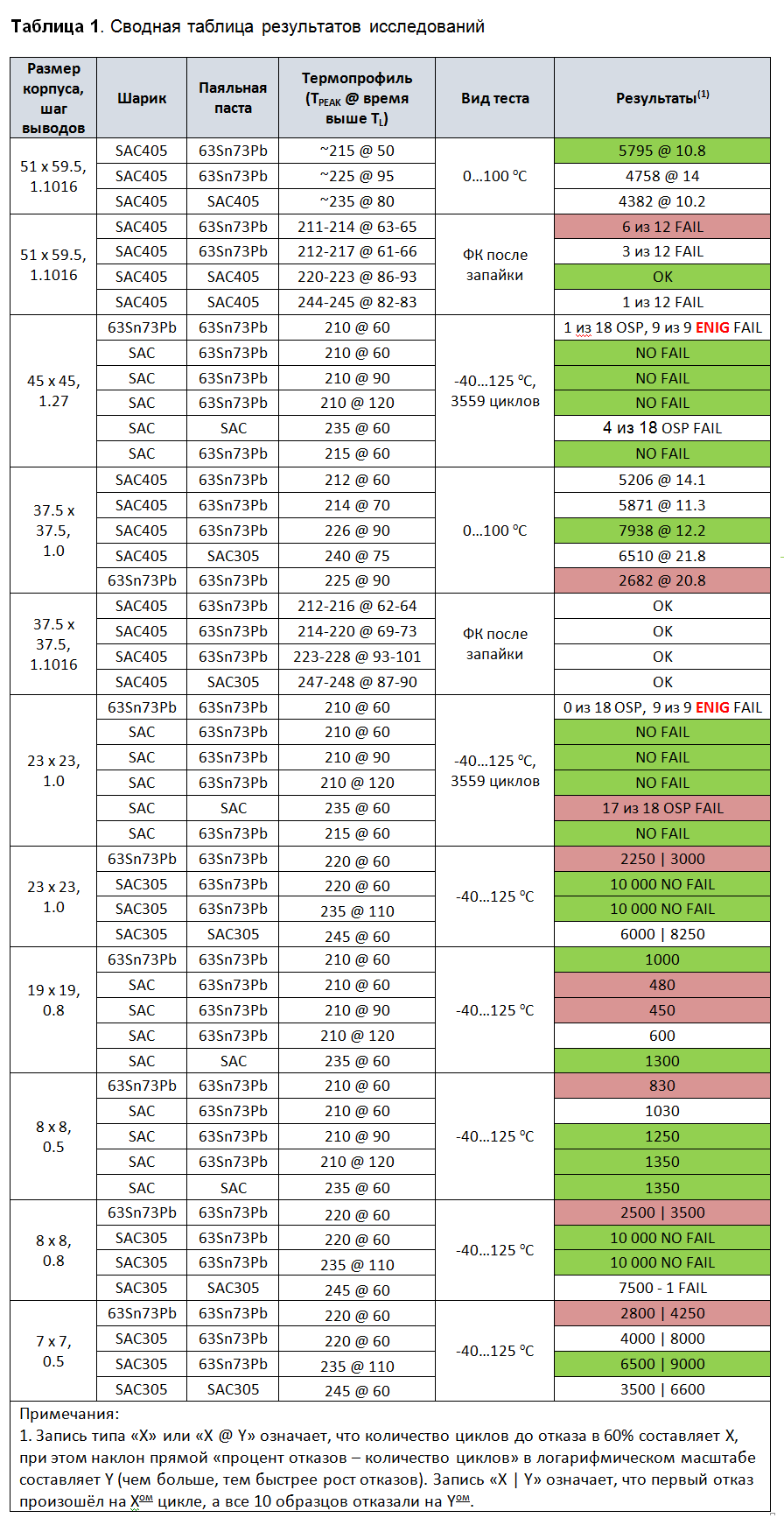

Bei der Analyse der präsentierten Daten sollten nur die relativen Zuverlässigkeitsindikatoren im Rahmen eines Experiments sowie die allgemeinen Gesetze für alle Experimente berücksichtigt werden. Eine der Schlussfolgerungen lautet wie folgt (dies wird auch in den meisten Artikeln durchgeführt): Wenn herkömmliches Löten für bleifreie Komponenten verwendet wird, muss ein vollständiges Mischen der Lote bei einer Spitzentemperatur von 220 ... 230 ° C erreicht werden, während die Lötzeit über T
L (SnPb) 60 ° C betragen sollte. 120 s, Zeit über T
L (SAC) ~ 30 s.
In den Artikeln wird nicht explizit angegeben, ob die BGA-Komponenten erneut zusammenballen, um bleihaltige Kugeln herzustellen. Die verringerten Zuverlässigkeitswerte für diese Fälle legen jedoch nahe, dass ein erneutes Balling zu einer Verringerung der Zuverlässigkeit führen kann. Ein Artikel über Reballing [8] berichtet über die positiven Ergebnisse des thermischen Zyklus. Die angegebene Versuchsdauer von 24 Stunden konnte jedoch keine ausreichende Anzahl von Zyklen liefern. Daher bleibt die Frage der Verringerung der Zuverlässigkeit infolge des Umballens offen, und gemischtes Löten mit experimenteller Auswahl eines thermischen Profils wird als Basisszenario empfohlen.
Ich fordere Sie dringend auf, die präsentierten Daten mit allgemeinen Zweifeln zu behandeln und Ihre experimentellen Erfahrungen in den Kommentaren mitzuteilen.Literatur
[1] Rick Gunn, "Mischmetalle wirken sich auf die Zuverlässigkeit aus"
[2] Richard Coyle, Raiyo Aspandiar usw. "Die Auswirkung von Pb-Mischungsniveaus auf die Zuverlässigkeit der Lötstelle und den Versagensmodus von rückwärtskompatiblen Kugelgitter-Array-Baugruppen mit hoher Dichte"
[3] Robert Kinyanjui, Quyen Chu usw. "Lötstellenzuverlässigkeit von Pb-freien BGA-Komponenten (Sn-Ag-Cu Ball Grid Array) im Sn-Pb-Montageprozess"
[4] Robert Kinyanjui, Raiyo Aspandiar usw., „Herausforderungen bei der Reflow-Profilierung von BGA-Paketen (Ball Grid Array) mit großer und hoher Dichte unter Verwendung abwärtskompatibler Montageprozesse“
[5] Adam R. Zbrzezny, Polina Snugovsky usw., "Zuverlässigkeitsuntersuchung gemischter BGA-Baugruppen"
[6] Richard Coyle, Richard Popowich, Peter Read usw. "Die Beziehung zwischen abwärtskompatibler Baugruppe und Mikrostruktur auf die thermische Ermüdungszuverlässigkeit eines extrem großen Kugelgitterarrays"
[7] Alan Brewin, Christopher Hunt usw. "Zuverlässigkeit von mit Mischlegierungslot gebildeten Verbindungen"
[8] J. Li, S. Poranki, M. Abtew usw. "Zuverlässigkeitsbewertung von reballed BGAs"