Artikel ini adalah artikel pertama tentang teknologi perakitan PCB. Seminar terakhir dari SOFT PCB dikhususkan untuk desain, memastikan manufakturabilitas papan sirkuit cetak (DFM, desain untuk pembuatan). Pertanyaan yang diajukan adalah tentang kesesuaian komponen BGA bebas timah untuk aplikasi yang sangat andal. Baik penyelenggara seminar maupun para peserta berbicara dengan percaya diri bahwa tidak ada yang melakukan operasi padat karya ini dan tidak pernah menemui masalah. Dalam artikel ini, saya akan secara kritis memeriksa masalah ini dan mencoba untuk menunjukkan bahaya dari pendapat "diterima secara umum di industri" tersebut tentang manfaat metode keraguan universal dari Rene Descartes lama.
Pada tahun 2006, Arahan
RoHS diadopsi membatasi penggunaan timbal dan elemen berbahaya lainnya yang diakui dalam elektronik konsumen dan industri. Hal ini menyebabkan fakta bahwa sebagian besar produsen komponen elektronik beralih ke rumah bebas timbal, dan memesan komponen dalam versi dengan lead yang mengandung timah tidak selalu tersedia. Pada saat yang sama, teknologi penyolderan yang menggunakan solder dengan kandungan timbal yang tinggi belum pergi ke mana pun (dalam
GOST R 56427-2015 , omong-omong, ini disebut tradisional). Pilihan solder dan / atau pasta solder tergantung pada pengembang PCB, jadi jika pilihannya adalah mendukung solder yang mengandung timbal, ada masalah penyolderan komponen bebas timbal (proses paduan campuran Inggris), terutama dalam kasus tipe BGA (proporsionalitas jenis solder). Masalah utama adalah efek pencampuran solder pada keandalan sambungan. GOST di atas memberikan jawaban yang jelas:
Untuk Kelas C RES menurut
GOST R IEC 61191-1-2010, kegagalan tidak dapat diterima, peralatan harus berfungsi kapan saja, termasuk dalam kondisi yang keras. Persyaratan ini tidak hanya berlaku untuk peralatan untuk aplikasi militer dan luar angkasa, misalnya, sistem industri yang bertanggung jawab juga harus dapat diandalkan.
Di mana persyaratan ini muncul dalam GOST? Ini adalah pertanyaan untuk pengembang standar, yang, kemungkinan besar, telah menerjemahkan standar asing, yang mungkin sudah berusia 5-10 tahun, dan dari mana asalnya tidak dipahami sama sekali. Dan pada saat yang sama, para peserta seminar, yang saya tulis di awal, mewakili sepotong elektronik domestik dari aplikasi yang bertanggung jawab, menggelengkan kepala mereka secara negatif pada kata "reballing". Mungkin mereka memiliki pengalaman positif, saya tidak berpendapat, saya hanya menentang generalisasi dan jaminan berdasarkan ketidaktahuan. Siapa di antara mereka (dan Anda pembaca) yang membaca standar? Dan mereka yang mengikuti standar yakin bahwa operasi ini dalam proses pembuatan diperlukan dalam kasus khusus mereka? Operasi itu sendiri tidak mengurangi keandalan? Siapa yang melakukan studi eksperimental tentang keandalan teknologi pemasangan permukaan yang digunakan? Karena seluruh titik dalam percobaan, dalam percobaan yang ditetapkan dengan benar. Sumber informasi lainnya adalah analisis data yang tersedia dari peneliti pihak ketiga. Di bawah ini saya akan merangkum beberapa artikel tentang keandalan komponen bebas timah solder.
Temperatur leleh (
liquidus ,
TL ) dari solder bebas timbal adalah 30-40
° C lebih tinggi dari pada solder yang mengandung timah, oleh karena itu, tergantung pada profil termal dari penyolderan dan distribusi medan termal pada papan sirkuit tercetak, berbagai derajat pencampuran dalam sambungan solder dapat diperoleh (Gbr. 1). Kehadiran zona konsentrasi dan ketidakhomogenan dari logam itu sendiri dan senyawa intermetalik dalam sambungan solder (Gbr. 2) mengurangi keandalan jangka panjangnya, karena struktur makro seperti itu adalah tempat yang paling mungkin untuk pembentukan dan perambatan retak (terutama pada suhu rendah). Meskipun sebagian besar artikel dari daftar pustaka memberikan analisis mikrophotograf dari penampang senyawa, teori terpadu tentang penyebab retak tidak dilacak.


Tabel 1 merangkum hasil kerja penelitian, yang didasarkan pada eksperimen khas berikut: untuk kombinasi tetap dari solder, komponen BGA (dalam beberapa percobaan, ini adalah tata letak komponen non-fungsional, di mana hanya ada interkoneksi untuk kesimpulan untuk membangun rangkaian seri), disegel dengan berbagai profil termal, thermocycled sampai terjadi kegagalan fungsional atau non-kontak. Ketergantungan pada ukuran kasing juga diselidiki, di sejumlah karya pengaruh lokasi komponen pada papan sirkuit tercetak, pengaruh perekat "kurang isi", permukaan papan sirkit tercetak, dll. Dipelajari.
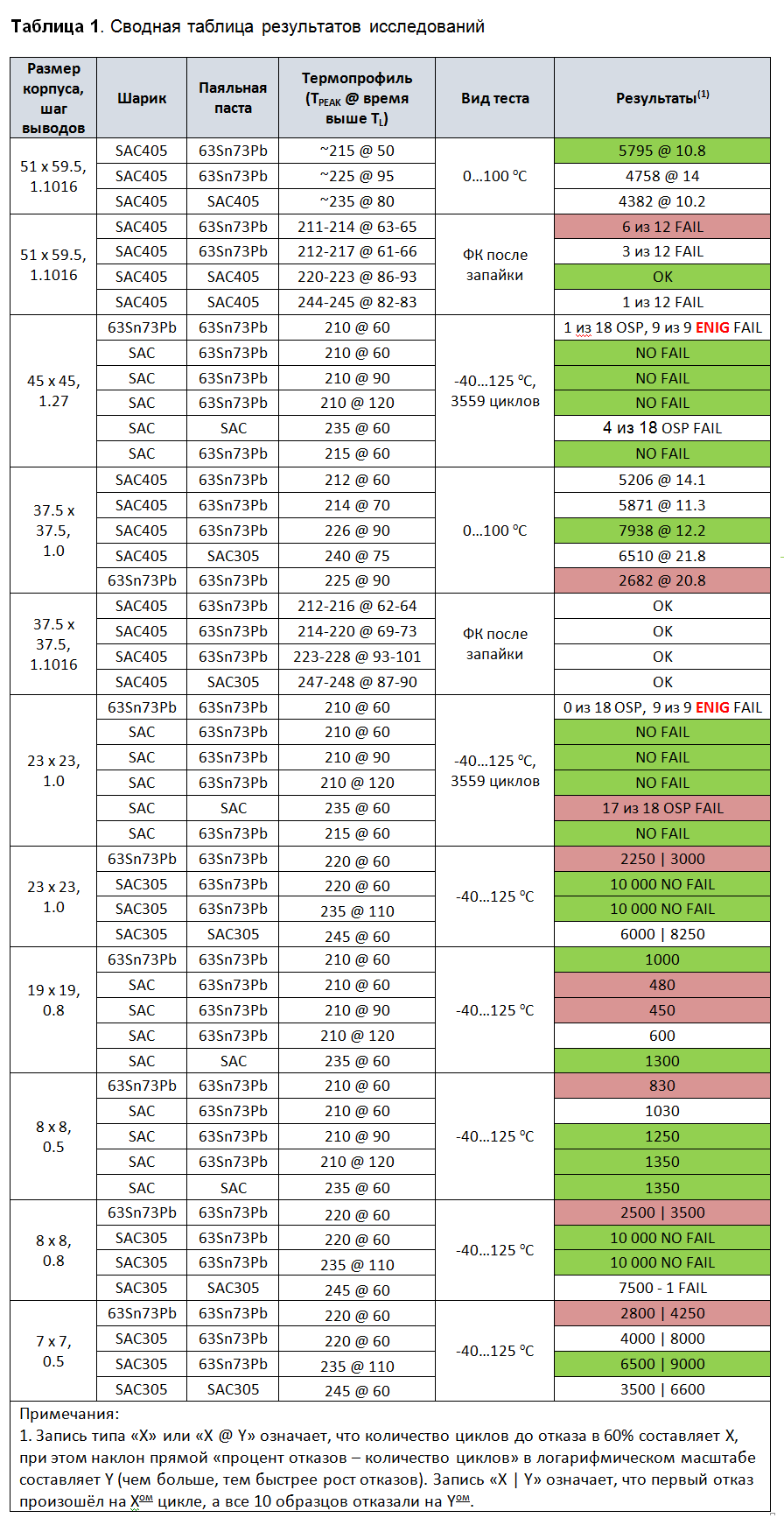

Saat menganalisis data yang disajikan, seseorang harus memperhatikan hanya indikator reliabilitas relatif dalam kerangka satu eksperimen, serta hukum umum untuk semua percobaan. Salah satu kesimpulan adalah sebagai berikut (ini juga dilakukan di sebagian besar artikel): ketika menggunakan solder tradisional untuk komponen bebas timbal, perlu untuk mencapai pencampuran lengkap solder pada suhu puncak 220 ... 230
o C, sedangkan waktu penyolderan di atas T
L (SnPb) harus 60- 120 dtk, waktu di atas T
L (SAC) ~ 30 dtk.
Tidak ada indikasi yang jelas dalam artikel apakah komponen BGA mengembang kembali untuk menghasilkan bola yang mengandung timbal, tetapi nilai keandalan yang lebih rendah untuk kasus ini menunjukkan bahwa pengocokan kembali dapat menyebabkan penurunan keandalan. Sebuah artikel tentang reballing [8] melaporkan hasil positif dari siklus termal, namun, durasi percobaan yang dinyatakan selama 24 jam tidak dapat memberikan jumlah siklus yang cukup. Oleh karena itu, pertanyaan untuk mengurangi keandalan akibat reballing tetap terbuka, dan penyolderan campuran dengan pemilihan profil termal eksperimental direkomendasikan sebagai skenario dasar.
Saya mendorong Anda untuk memperlakukan data yang disajikan dengan keraguan universal dan membagikan pengalaman eksperimental Anda dalam komentar.Sastra
[1] Rick Gunn, ”Logam Campuran Berdampak pada Keandalan”
[2] Richard Coyle, Raiyo Aspandiar, dll. "Pengaruh Tingkat Pencampuran Pb pada Keandalan Solder Joint dan Mode Kegagalan dari Rakitan Array Bola Kotak Berkepadanan Tinggi, Kepadatan Tinggi"
[3] Robert Kinyanjui, Quyen Chu, dll. “Keandalan Solder Bersama untuk Komponen BGA Sn-Ag-Cu Ball Grid (BGA) bebas Pb dalam Proses Perakitan Sn-Pb”
[4] Robert Kinyanjui, Raiyo Aspandiar, dll, "Tantangan dalam Reflow Profileing Paket Bays Grid Grid (BGA) Besar dan Kepadatan Tinggi Menggunakan Proses Perakitan Kompatibel yang Mundur"
[5] Adam R. Zbrzezny, Polina Snugovsky, dll, ”Investigasi Keandalan dari Majelis BGA Campuran”
[6] Richard Coyle, Richard Popowich, Peter Read, dll. “Hubungan antara Rakitan Kompatibel Mundur dan Mikrostruktur pada Keandalan Kelelahan Termal pada Larik Kotak Bola Yang Sangat Besar”
[7] Alan Brewin, Christopher Hunt, dll. “Keandalan Sambungan Dibentuk Dengan Solder Campuran Paduan”
[8] J. Li, S. Poranki, M. Abtew, dll. “Penilaian Keandalan BGA Reballed”