Este artigo é o primeiro artigo sobre tecnologias de montagem de PCB. O último seminário da PCB SOFT foi dedicado ao design, garantindo a capacidade de fabricação da placa de circuito impresso (DFM, design for manufacturing). Foi levantada a questão sobre a adequação do reballing de componentes BGA sem chumbo para aplicativos altamente confiáveis. Tanto os organizadores do seminário quanto os participantes falaram confiantes de que ninguém estava realizando essa operação de trabalho intensivo e nunca havia encontrado nenhum problema. Neste artigo, examinarei criticamente essa questão e tentarei mostrar o perigo de tais opiniões "geralmente aceitas na indústria" sobre os benefícios do método da dúvida universal do antigo René Descartes.
Em 2006, a Diretiva
RoHS foi adotada restringindo o uso de chumbo e outros elementos prejudiciais reconhecidos em eletrônicos de consumo e industriais. Isso levou ao fato de a maioria dos fabricantes de componentes eletrônicos terem mudado para caixas sem chumbo, e o pedido de componentes em versões com fios que contenham chumbo nem sempre está disponível. Ao mesmo tempo, a tecnologia de solda usando soldas com alto teor de chumbo não foi a lugar nenhum (no
GOST R 56427-2015 , a propósito, é chamado de tradicional). A escolha da solda e / ou pasta de solda é do desenvolvedor do PCB; portanto, se a escolha for feita em favor da solda contendo chumbo, há um problema de soldar componentes sem chumbo (processo de liga mista em inglês), especialmente em casos do tipo BGA (proporcionalidade das ações de soldas). A questão principal é o efeito da mistura de solda na confiabilidade da junta. O GOST acima fornece uma resposta inequívoca:
Para RES Classe C de acordo com
GOST R IEC 61191-1-2010, uma falha é inaceitável, o equipamento deve funcionar a qualquer momento, inclusive em condições adversas. Esses requisitos não se aplicam apenas a equipamentos para aplicações militares e espaciais, por exemplo, sistemas industriais responsáveis também devem ser confiáveis.
Onde esse requisito surgiu no GOST? Essa é uma pergunta para os desenvolvedores do padrão, que provavelmente traduziram o padrão estrangeiro, que provavelmente já tem entre 5 e 10 anos de idade, e de onde veio ele não é compreendido. E, ao mesmo tempo, os participantes do seminário, sobre o qual escrevi no início, representando uma parte da eletrônica doméstica de aplicação precisamente responsável, balançaram a cabeça negativamente com a palavra "reballing". Talvez eles tenham uma experiência positiva, não discuto, sou simplesmente contra generalizações e garantias baseadas na ignorância. Quem deles (e de vocês leitores) leu o padrão? E aqueles que seguem o padrão têm certeza de que essa operação no processo de fabricação é necessária no seu caso particular? A operação em si não reduz a confiabilidade? Quem conduziu um estudo experimental da confiabilidade da tecnologia de montagem em superfície usada? Porque o ponto principal está no experimento, no experimento definido corretamente. Outra fonte de informação é a análise dos dados disponíveis de pesquisadores de terceiros. Abaixo, resumirei vários artigos sobre a confiabilidade dos componentes sem solda de chumbo.
A temperatura de fusão (
liquidus ,
LT ) das soldas sem chumbo é 30-40
° C superior à das soldas contendo chumbo; portanto, dependendo do perfil térmico da solda e da distribuição do campo térmico na placa de circuito impresso, podem ser obtidos vários graus de mistura na junta soldada (Fig. 1). A presença de zonas de concentração e heterogeneidades dos próprios metais e compostos intermetálicos na junta de solda (Fig. 2) reduz sua confiabilidade a longo prazo, uma vez que essas macroestruturas são os locais mais prováveis de formação e propagação de fissuras (especialmente a baixas temperaturas). Embora a maioria dos artigos da lista de literatura forneça uma análise de microfotografias da seção transversal dos compostos, uma teoria unificada da causa do craqueamento não é traçada.


A Tabela 1 resume os resultados do trabalho de pesquisa, que foi baseado no seguinte experimento típico: para uma combinação fixa de soldas, o componente BGA (em alguns experimentos, este é um layout de componente não funcional, no qual existem apenas interconexões para as conclusões para a construção de um circuito serial), seladas com vários perfis térmicos, termociclado até uma falha funcional ou não contato. Também foi investigada a dependência do tamanho do caso, em vários trabalhos a influência da localização do componente na placa de circuito impresso, o efeito do adesivo como "sub-enchimento", o acabamento da placa de circuito impresso, etc.
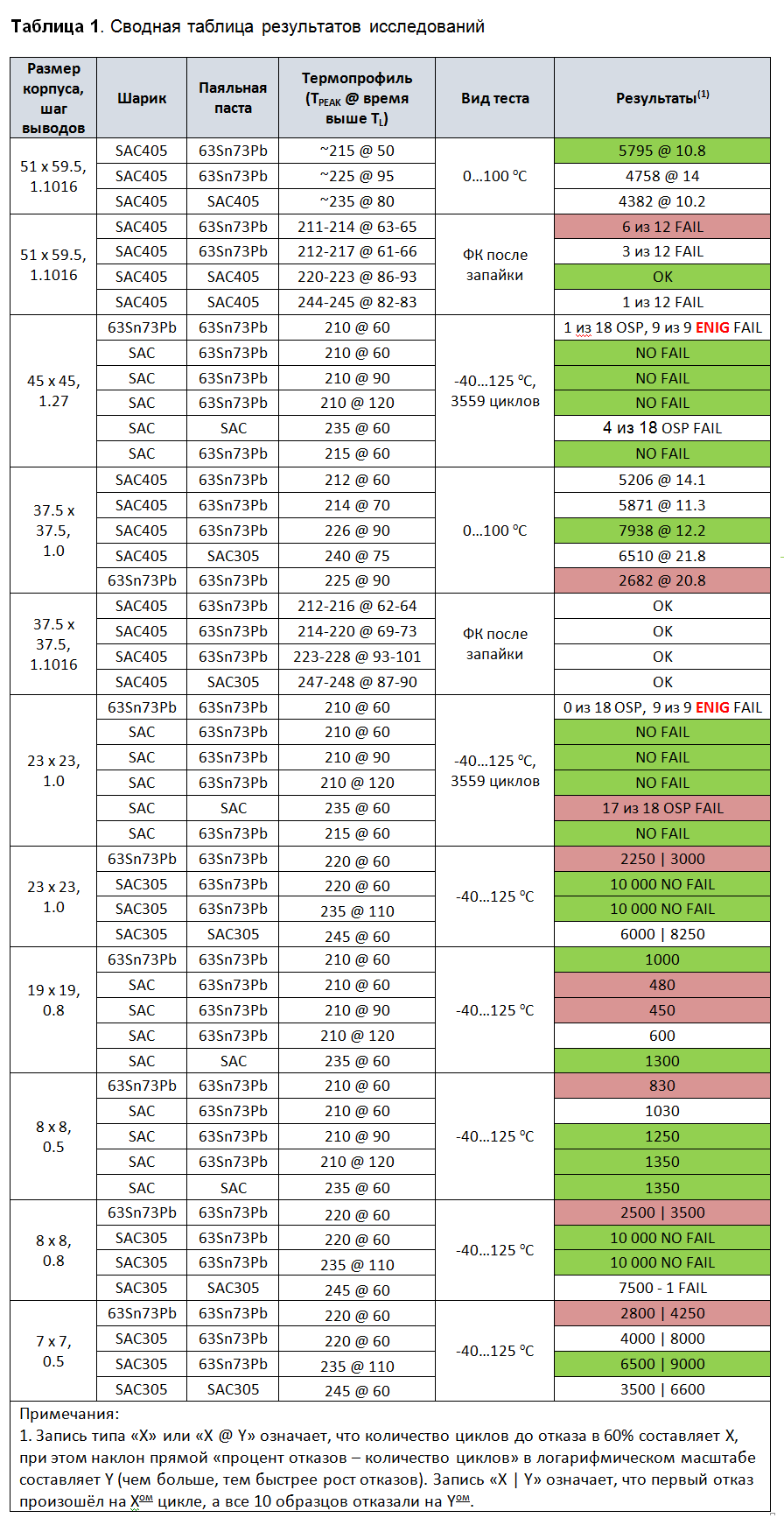

Ao analisar os dados apresentados, deve-se prestar atenção apenas aos indicadores de confiabilidade relativa no âmbito de um experimento, bem como às leis gerais de todos os experimentos. Uma das conclusões é a seguinte (também é feita na maioria dos artigos): ao usar solda tradicional para componentes sem chumbo, é necessário obter uma mistura completa de soldas a uma temperatura de pico de 220 ... 230
o C, enquanto o tempo de solda acima de T
L (SnPb) deve ser de 60- 120 s, tempo acima de
TL (SAC) ~ 30 seg.
Não há indicação explícita nos artigos se os componentes do BGA foram re-balling para produzir bolas contendo chumbo, mas os valores mais baixos de confiabilidade para esses casos sugerem que o re-balling pode levar a uma diminuição na confiabilidade. Um artigo sobre reballing [8] relata os resultados positivos da ciclagem térmica, no entanto, a duração declarada do experimento de 24 horas não pode fornecer um número suficiente de ciclos. Portanto, a questão de reduzir a confiabilidade como resultado do reballing permanece em aberto, e a soldagem mista com seleção experimental de um perfil térmico é recomendada como cenário básico.
Peço que você trate os dados apresentados com dúvida universal e compartilhe sua experiência experimental nos comentários.Literatura
[1] Rick Gunn, "impacto de metais mistos na confiabilidade"
[2] Richard Coyle, Raiyo Aspandiar, etc. “O efeito dos níveis de mistura de Pb na confiabilidade da junta de solda e no modo de falha de conjuntos de matrizes de grade de esferas de alta densidade e compatíveis com versões anteriores”
[3] Robert Kinyanjui, Quyen Chu, etc. “Confiabilidade da junta de solda de componentes de matriz de bola Sn-Ag-Cu (BGA) sem Pb no processo de montagem de Sn-Pb”
[4] Robert Kinyanjui, Raiyo Aspandiar, etc., “Desafios no empacotamento de perfis de refluxo grandes e de alta densidade de grade de esferas (BGA) usando processos de montagem compatíveis com versões anteriores”
[5] Adam R. Zbrzezny, Polina Snugovsky, etc., "Investigação de Confiabilidade de Assembléias BGA Mistas"
[6] Richard Coyle, Richard Popowich, Peter Read, etc. “A relação entre montagem compatível com versões anteriores e microestrutura na confiabilidade de fadiga térmica de uma matriz de grade de esferas extremamente grande”
[7] Alan Brewin, Christopher Hunt, etc. “Confiabilidade de juntas formadas com solda de liga mista”
[8] J. Li, S. Poranki, M. Abtew, etc. “Avaliação da confiabilidade de BGAs re-acionados”